01
Introduksjon
Wafer-terninger er en viktig del av produksjonen av halvlederenheter. Terningsmetoden og kvaliteten påvirker waferens tykkelse, ruhet, dimensjoner og produksjonskostnader direkte, og har en betydelig innvirkning på enhetens fabrikasjon. Silisiumkarbid, som tredje-generasjons halvledermateriale, er et viktig materiale som driver den elektriske revolusjonen. Produksjonskostnadene for krystallinsk silisiumkarbid av høy-kvalitet er ekstremt høy, og folk håper generelt å kutte en stor silisiumkarbidblokk i så mange tynne silisiumkarbidplater som mulig. Samtidig har veksten i industrien ført til stadig større waferstørrelser, noe som har økt kravene til terningsprosesser. Silisiumkarbid er imidlertid ekstremt hardt, med en Mohs-hardhet på 9,5, nest etter diamant (10), og det er også sprøtt, noe som gjør det vanskelig å kutte. For tiden bruker industrielle metoder generelt slurry wire saging eller diamant wire saging. Under kapping plasseres faste trådsager med lik avstand rundt silisiumkarbidblokken, og barren kuttes ved hjelp av strakte trådsager. Ved å bruke trådsagmetoden tar det omtrent 100 timer å skille wafere fra en 6-tommers diameter barre. De resulterende skivene har relativt brede snitt, grovere overflater og materialtap så høyt som 46%. Dette øker kostnadene ved bruk av silisiumkarbidmaterialer og begrenser deres utvikling i halvlederindustrien, noe som understreker det presserende behovet for forskning på nye teknologier for terninger av silisiumkarbidwafer.
De siste årene har bruken av laserskjæringsteknologi blitt stadig mer populær i produksjon av halvledermaterialer. Denne metoden fungerer ved å bruke en fokusert laserstråle for å modifisere materialets overflate eller interiør, og dermed separere den. Som en ikke-kontaktprosess unngår den verktøyslitasje og mekanisk påkjenning. Derfor forbedrer det waferoverflatens ruhet og presisjon, eliminerer behovet for påfølgende poleringsprosesser, reduserer materialtap, reduserer kostnadene og minimerer miljøforurensning forårsaket av tradisjonell sliping og polering. Laserskjæringsteknologi har lenge vært brukt på kutting av silisiumblokker, men dens anvendelse i silisiumkarbidfeltet er fortsatt umoden. For tiden er det flere hovedteknikker.
02
Vann-veiledet laserskjæring
Vann-guidet laserteknologi (Laser MicroJet, LMJ), også kjent som lasermikro-jetteknologi, fungerer etter prinsippet om å fokusere en laserstråle på en dyse når den passerer gjennom et trykk-modulert vannkammer. En lav-vannstråle skytes ut fra dysen, og på grunn av forskjellen i brytningsindeks ved vann-luftgrensesnittet, dannes en lysbølgeleder som lar laseren forplante seg langs vannstrømmens retning. Dette leder en-høytrykksvannstråle for å behandle og kutte materialoverflaten. Den største fordelen med vann-veiledet laserskjæring ligger i skjærekvaliteten. Vannstrømmen avkjøler ikke bare skjæreområdet, reduserer termisk deformasjon og termisk skade på materialet, men fjerner også prosessavfall. Sammenlignet med wiresagkapping er det betydelig raskere. Men fordi vann absorberer forskjellige laserbølgelengder i varierende grad, er laserbølgelengden begrenset, primært til 1064 nm, 532 nm og 355 nm.
I 1993 foreslo den sveitsiske forskeren Beruold Richerzhagen denne teknologien for første gang. Han grunnla Synova, et selskap dedikert til forskning, utvikling og kommersialisering av vann--veiledet laserteknologi, som er internasjonalt i forkant. Innenlandsk teknologi ligger relativt bak, men selskaper som Innolight og Shengguang Silicon Research utvikler den aktivt.
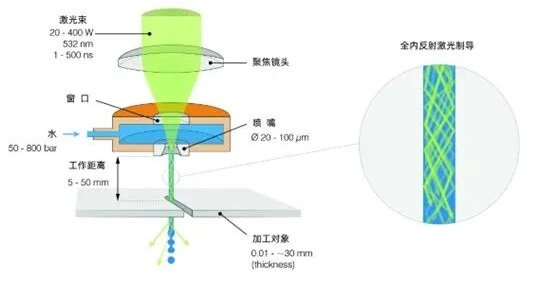
03
Stealth Dicing
Stealth Dicing (SD) er en teknikk der en laser fokuseres inne i en silisiumkarbidskive gjennom overflaten for å danne et modifisert lag på ønsket dybde, noe som muliggjør waferseparasjon. Siden det ikke er kutt på waferoverflaten, kan høyere prosesseringspresisjon oppnås. SD-prosessen med nanosekund-pulslasere har allerede blitt brukt industrielt for å separere silisiumskiver. Under SD-behandlingen av silisiumkarbid indusert av nanosekundpulslasere, er imidlertid pulsvarigheten mye lengre enn koblingstiden mellom elektroner og fononer i silisiumkarbid (på pikosekundskalaen), noe som resulterer i termiske effekter. Den høye termiske inngangen på waferen gjør ikke bare separasjonen tilbøyelig til å avvike fra ønsket retning, men genererer også betydelig restspenning, som fører til brudd og dårlig spaltning. Derfor, når du behandler silisiumkarbid, bruker SD-prosessen vanligvis ultrakorte pulslasere, noe som i stor grad reduserer termiske effekter.

Det japanske selskapet DISCO har utviklet en laserskjæringsteknologi kalt Key Amorphous-Black Repetitive Absorption (KABRA). For eksempel, ved behandling av 6-tommers diameter, 20 mm tykke silisiumkarbidblokker, økte det produktiviteten til silisiumkarbidplater fire ganger. KABRA-prosessen fokuserer i hovedsak laseren inne i silisiumkarbidmaterialet. Gjennom 'amorf-svart repeterende absorpsjon' spaltes silisiumkarbidet til amorft silisium og amorft karbon, og danner et lag som fungerer som et waferseparasjonspunkt, kjent som det svarte amorfe laget, som absorberer mer lys, noe som gjør det mye lettere å skille skivene.

Cold Split wafer-teknologien utviklet av Siltectra, som ble kjøpt opp av Infineon, kan ikke bare dele opp ulike typer blokker i wafere, men reduserer også materialtapet med opptil 90 %, hvor hver wafer taper så lite som 80 µm, noe som til slutt reduserer de totale produksjonskostnadene for enheten med opptil 30 %. Cold Split-teknologien involverer to trinn: For det første bestråler en laser blokken for å lage et delamineringslag, noe som forårsaker intern volumekspansjon i silisiumkarbidmaterialet, som genererer strekkspenning og danner en veldig smal mikro-sprekk; deretter gjør et polymerkjøletrinn mikro-sprekken til en hovedsprekker, som til slutt skiller waferen fra den gjenværende blokken. I 2019 evaluerte en tredjepart denne teknologien og målte overflateruheten Ra til de delte skivene til å være mindre enn 3 µm, med de beste resultatene på mindre enn 2 µm.

Den modifiserte laserskjæringen utviklet av det kinesiske selskapet Han's Laser er en laserteknologi som brukes til å skille halvlederskiver i individuelle brikker eller dyser. Denne prosessen bruker også en presis laserstråle for å skanne og danne et modifisert lag inne i waferen, slik at waferen kan sprekke langs laserskanningsbanen under påført stress, og oppnå presis separasjon.
Figur 5. Modifisert laserskjæringsprosessflyt
For tiden har innenlandske produsenter mestret slurry-basert silisiumkarbidskeringsteknologi. Imidlertid har slurry terninger høyt materialtap, lav effektivitet og alvorlig forurensning, og blir gradvis erstattet av diamanttrådsteknologi. Samtidig skiller laserterninger seg ut på grunn av ytelsen og effektivitetsfordelene. Sammenlignet med tradisjonelle mekaniske kontaktbehandlingsteknologier, gir den mange fordeler, inkludert høy prosesseringseffektivitet, smale riller og høy snitttetthet, noe som gjør den til en sterk konkurrent for å erstatte diamanttrådsskjæring. Det åpner en ny vei for bruk av neste-generasjons halvledermaterialer som silisiumkarbid. Med utviklingen av industriell teknologi og den kontinuerlige økningen i størrelser på silisiumkarbidsubstrater, vil silisiumkarbidskæreteknologi utvikle seg raskt, og effektiv laserskjæring av-kvalitet vil være en viktig trend for fremtidig silisiumkarbidskjæring.









